随着集成电路的发展,点火模块功能不断增强,引线越来越多,而体积却越来越小,导致焊盘(pad)在整个电路中所占的面积比不断上升。引线键合(Wire bonding)作为半导体行业芯片封装的互连工艺,逐渐成为解决产品小型化的一个关键技术。为实现点火模块小型化,轻量化的目标,满足客户对产品升级换代需求,健科电子引进美国深腔焊工艺,帮助缩小产品尺寸并增强焊接稳定性。

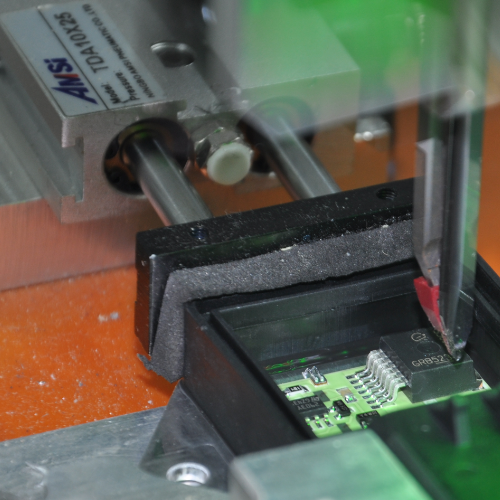
深腔焊属于引线键合的一种,其原理是通过超声波使劈刀发生水平弹性振动,同时施加向下压力。劈刀在两种力作用下带动引线在焊区金属表面迅速摩擦,引线发生塑性变形,与键合区紧密接触完成焊接。
健科电子Wire bonding有金线和铝线两种不同制程,均在千级无尘车间里进行。
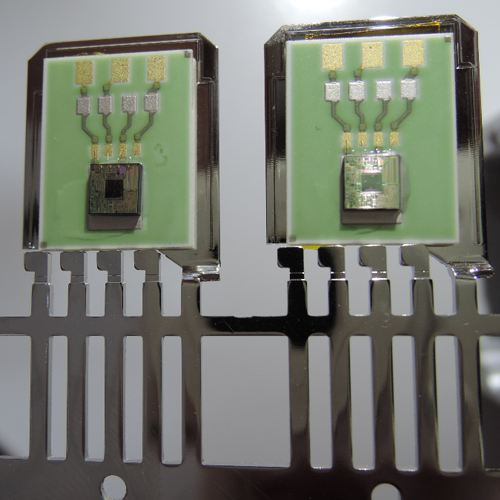

不同制程类型的采用取决于具体的应用场合。比如健科运用金线邦定压力传感器JK-SP001芯片和陶瓷基板,因为金线线径小,具有很好的抗拉强度和延展率,所以可以行形成各种弧形,且具有抗氧化侵蚀能力和高导电性,同时可以很容易地通过超声波焊接技术键合到指定位置;高纯铝丝导电性好,耐蚀性优,同金丝相比成本低,与铝膜不产生金属间化合物,故铝线多用于晶体管,集成电路的组装,健科的塑封模块和塑框模块就大量运用的粗铝丝超声波键合工艺。
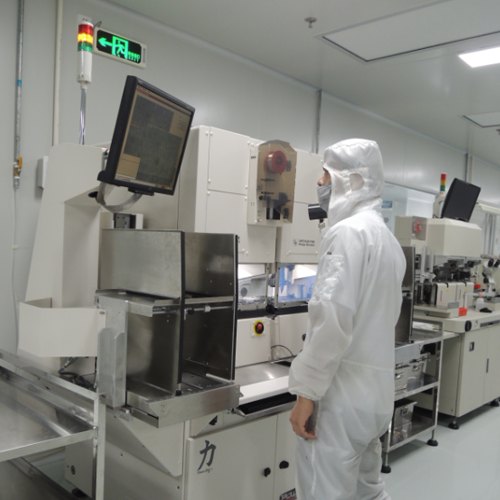

键合工序是点火模块生产过程中的关键工序之一,人机料法环的任何一个环节都会对键合可靠性造成影响,从而导致电路失效。键合质量的好坏往往通过破坏性实验判定,通常使用键合拉力测试(Bond Pull Test)。影响BPT结果的因素除了工艺参数以外,还有键合材料(材质、直径、强度和刚度)、焊盘材质、吊钩位置、弧线高度等。健科电子通过对键合过程中可能影响焊接可靠性的因素进行实验与分析,对可能出现的问题进行预防,以提高键合的可靠性,从而提高器件的整体性能。

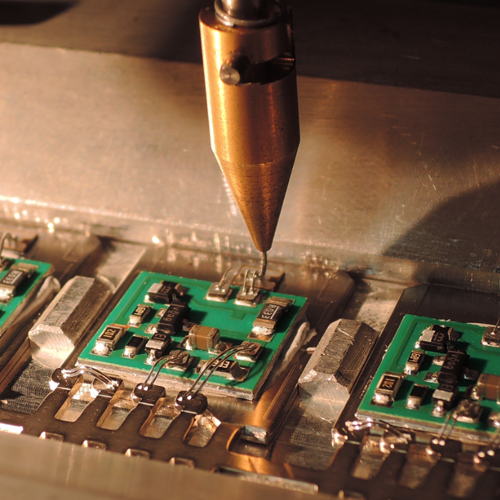
目前Wire bonding在电动汽车领域技术有了新的发展。2006年TESLA率先将wire bonding技术运用到电芯连接方案。在TESLA看来,传统的焊接工艺十分耗时、容易失败。同时也很难测试电池之间的连接、导体是否存在问题。

引线键合作为点火模块生产工序中的关键,在未来相当长一段时间仍将是模块内部连接的主流方式。随着封装尺寸的减小,新材料、新封装形式的应用,健科电子对深腔焊的应用会越来越广泛。

